レゾナックは9月19日、半導体デバイスの製造工程(前工程)や半導体パッケージング工程(後工程)において、ウエハ等をガラスなどのキャリアに一時的に固定するための仮固定フィルム、およびその剥離プロセスを新たに開発したと発表した。
同技術は、キャリアからウエハ等を剥離するために、キセノン(Xe)フラッシュ光照射を利用しており、ウエハサイズからパネルサイズまで適用可能となる。また、一般的なレーザー照射に比べ、短時間、かつ「すす」のような異物を出さずに剥離できるクリーンな技術であり、日本、米国、韓国、中国、台湾地域で、特許を取得している。
同社は、新規仮固定プロセスの構築を共に進めていける開発パートナーを探すとともに、新規仮固定フィルム、およびその剥離プロセスの市場展開を目指す。
先端半導体の前工程、後工程では、作業性向上のため、ウエハやチップは仮固定材でガラスなどのキャリアに一時的に接着される。そして、さまざまな加工プロセスを経た後、ウエハやパッケージは仮固定材とともにキャリアから剥離される。このため、仮固定材の性能としては、あらゆる加工プロセスへ適合することに加えて、残った仮固定材を容易に除去できることが求められる。また、剥離方式としては、高い歩留まりと生産性を実現するために、ウエハやパッケージにダメージを与えることなく、短時間で剥離できることが求められる。さらに、昨今、後工程においても前工程と同様にクリーンなプロセスが求められており、一般的なレーザー照射による剥離方式で発生する「すす」が課題となっている。
同社の仮固定フィルムは、高い耐熱性、耐薬品性を備え、仮固定時は十分な接着性を示し、キャリアから剥離した後は常温で簡単に、残留物を残すことなく剥がすことができる。また、キャリアから剥離する方式としては、大面積一括照射が可能で、瞬間的に高いエネルギーを出力できるXeフラッシュ光照射を採用しており、ガラスキャリア上に形成した金属層を局所的に加熱・変形させることによって、ウエハやパッケージに熱や物理的な負荷をかけることなく、短時間で剥離することが可能である。さらに、樹脂分解を伴うことなく剥離できるため、レーザー照射時に発生する「すす」のような異物が発生しないクリーンなプロセスであるという特長がある。
本仮固定フィルム、およびその剥離プロセスは、メモリ半導体、ロジック半導体、パワー半導体、先端半導体パッケージのいずれの製造工程においても好適と考えている。同社は、今後も、共創を通じて半導体領域における技術革新に貢献する。
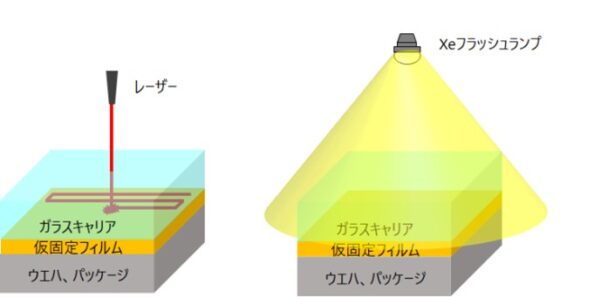
レーザーおよびXe光照射のイメージ
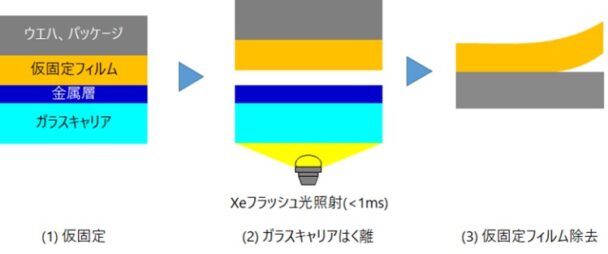
Xe光照射による仮固定プロセスイメージ

ピールオフによる仮固定フィルム除去の様子








